
1、G工程
成膜工程——G層Sputter (AL-Nb, Mo-Nd)

PR曝光工程——G-Mask PR曝光

刻蝕工程——G層濕刻

剝離

2、D/I工程
成膜工程——PCVD (SiNx)

成膜工程——PCVD (3層CVD)

成膜工程——D層 Sputter (Cr)

PR曝光工程——D-Mask PR曝光

刻蝕工程——D層濕刻1

Island干刻

D層濕刻2

Channel干刻
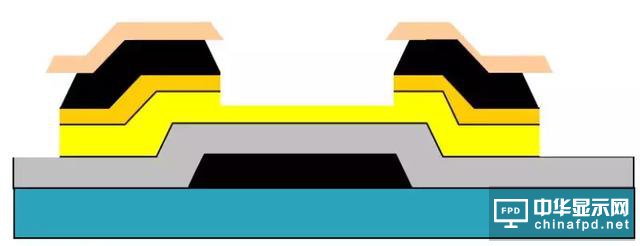
剝離工程——剝離

3、C工程
成膜工程——PECVD (SiNx)
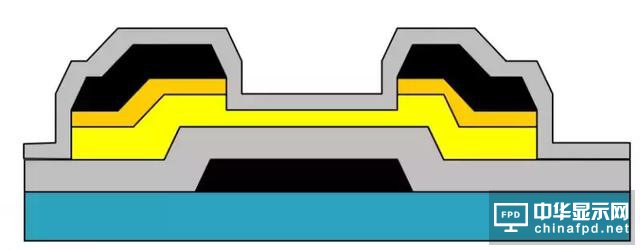
PR曝光工程——C-Mask PR曝光
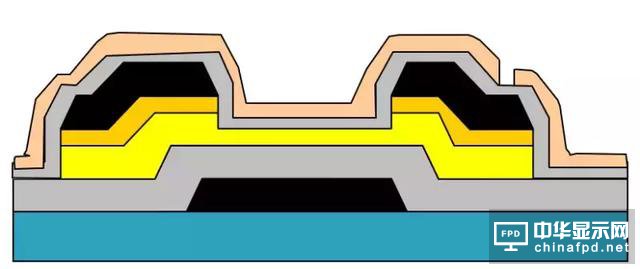
刻蝕工程——Contact Hole干刻
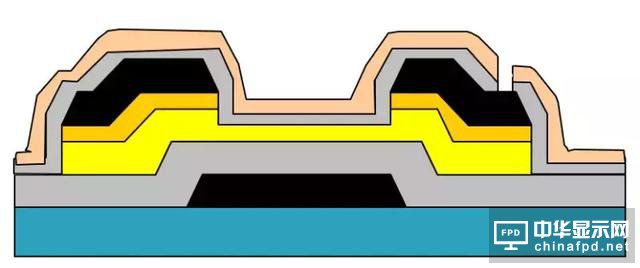
剝離
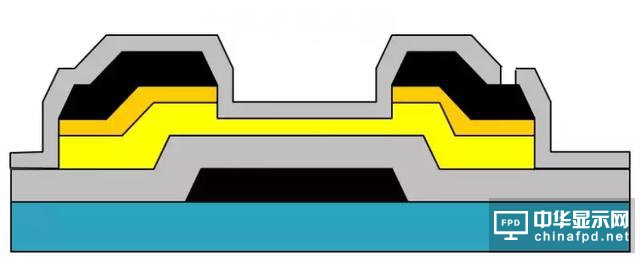
4、PI工程
成膜工程——Sputter (ITO)
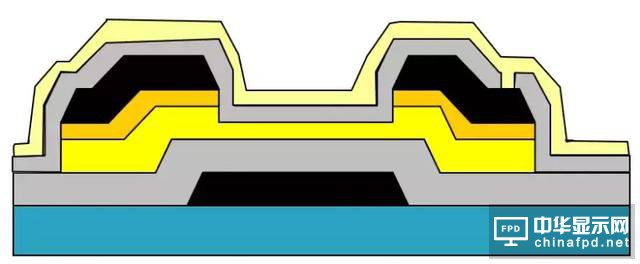
PR曝光工程——PI-Mask PR曝光
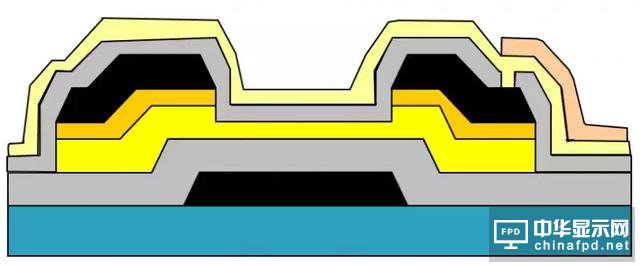
刻蝕工程——ITO濕刻
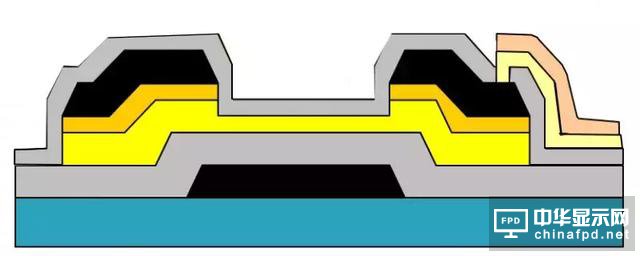
剝離

5、ARRAY工藝介紹
洗凈:清潔基板表面,防止成膜不良
濺射(SPUTTER):成Gate膜、D/S膜和Pixel膜
PECVD:成a-Si膜和SiNx膜
PR/曝光:形成與MASK圖案相一致的光刻膠圖案
濕刻(WE):刻蝕掉未被光刻膠掩蔽的金屬膜
干刻(DE):刻蝕掉未被光刻膠掩蔽的非金屬膜
剝離:去掉殘余的光刻膠
退火:修復晶體損傷,改善晶體性質
檢查修復:監控產品不良,修復不良
5.1 洗凈
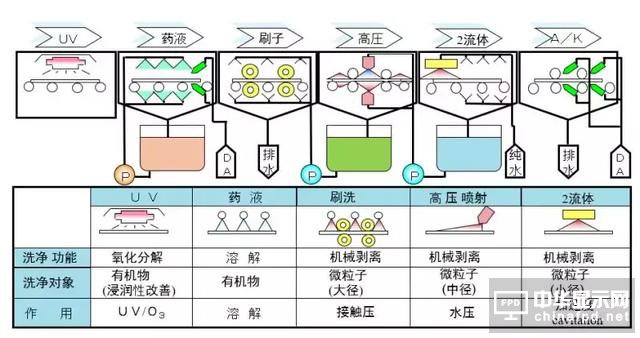
5.2 洗凈方法及原理概述
#p#分頁標題#e#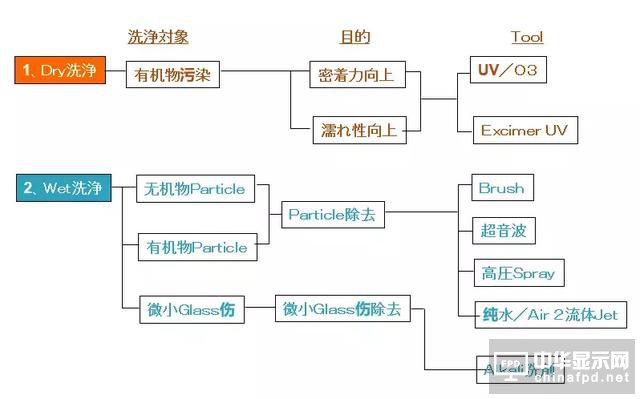
5.3 Sputter
濺射( Sputter )是指利用電場加速的氣體離子對靶材的轟擊,使成膜材料從靶材轉移到基板的物理成膜方法。
Sputter在工藝流程中的位置:
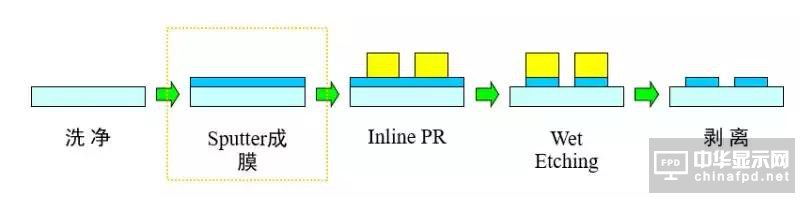
TFT中Sputter薄膜的種類和作用:
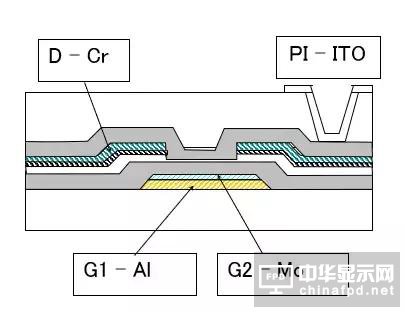
G配線:Al,傳遞掃描信號
D配線:Cr,傳遞數據信號
像素電極:ITO,存儲數據信號
5.4 Sputter設備

5.5 PECVD
G-絕緣膜:SiNx,絕緣
a-Si:非晶硅,導電溝道
n+a-Si:N摻雜非晶硅,歐姆接觸
PA-SiNx:SiNx,保護
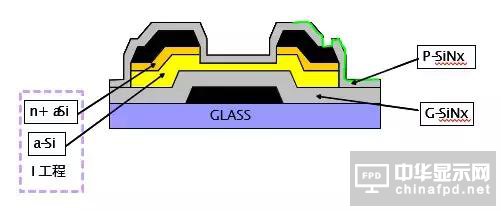

5.6 PR/曝光
由洗凈、涂覆、曝光、顯影四大部分組成。
洗凈: Excimer UV →RB+AAJet→直水Spray→A/k
涂覆: 除水干燥→ Slit涂覆→ Spin 涂覆→減壓干燥→端面清洗→前烘
曝光
顯影:顯影1→顯影2→循環純水Spray→直水Spray→A/K →后烘
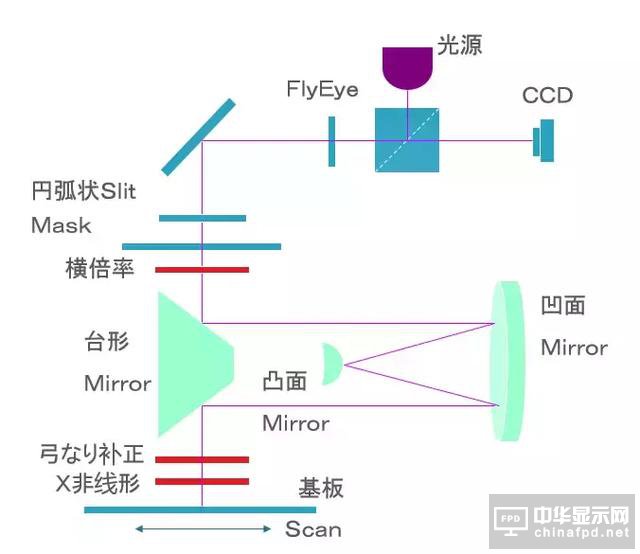
↓↓
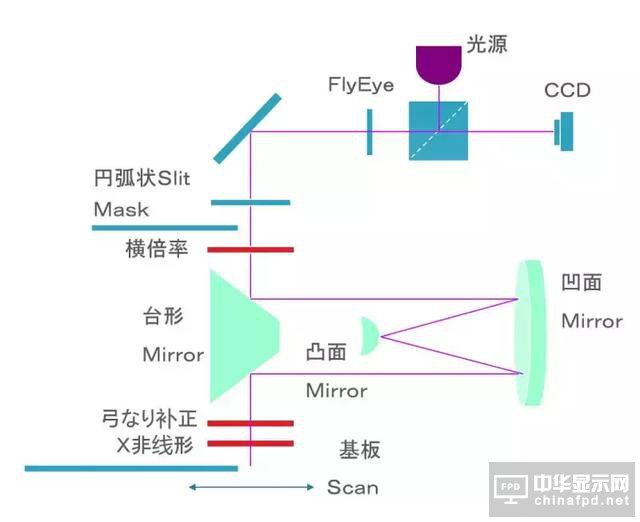
5.7 顯影
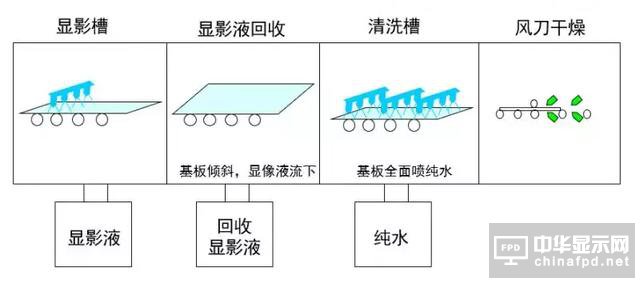
5.8 濕刻
濕刻的目的
濕刻是通過對象材料(一般為金屬導電膜)與刻蝕液之間的化學反應,對對象材料進行刻蝕的過程。
在TFT-LCD工藝中,主要是對Gate層(Mo/Al)、Drain層(Cr)及像素層(ITO)進行刻蝕。
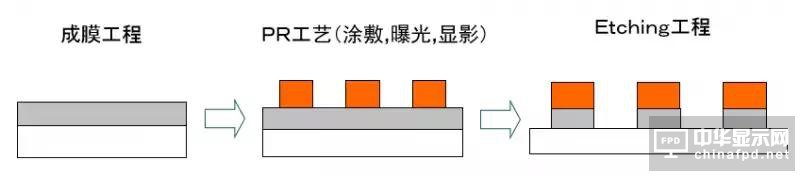
濕刻設備概要

濕刻裝置的構成
Etching槽:對基板進行刻蝕處理
水洗槽:通過純水將刻蝕液沖洗
干燥槽:用A/K干燥基板
5.9 干刻
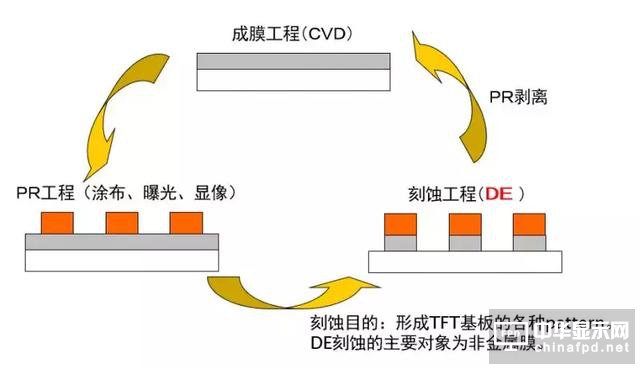
干刻原理:
反應氣體在高頻電場作用下發生等離子體(Plasma)放電。
等離子體與基板發生作用將沒有被光刻膠掩蔽的薄膜刻蝕掉。
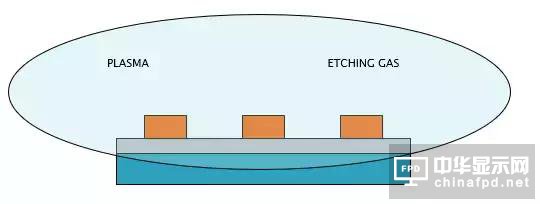
干刻裝置:
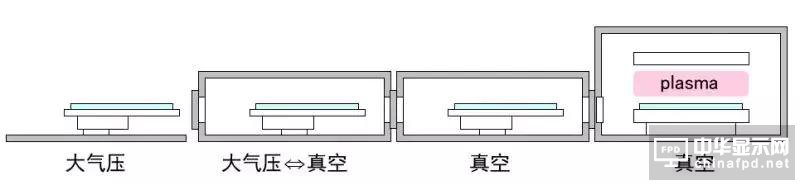
大氣Robot——從Cassette和L/L之間的搬送
L/L (Load Lock)——大氣壓和真空兩種狀態之間的切換
T/C (Transfer Chamber)——L/L和P/C之間的搬送。防止不純物進入P/C,P/C內的特氣外泄
P/C (Process Chamber)——真空中進行Plasma的物理、化學反應,進行刻蝕
5.10 剝離
剝離簡介:刻蝕(干刻、濕刻)完成后除去光刻膠的過程。
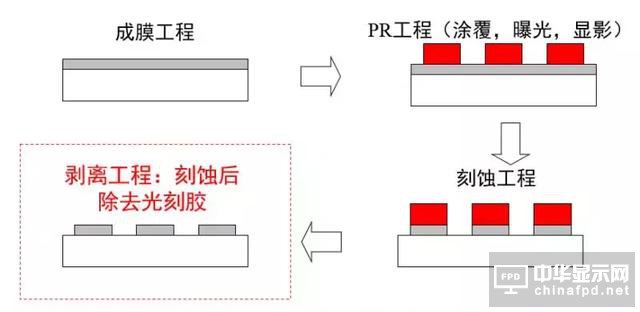
剝離裝置示意圖:

剝離槽:利用剝離液溶解并剝離光刻膠
IPA槽:利用IPA置換剝離液。(防止Al腐蝕)
水洗槽:用純水洗凈處理液
干燥槽:利用A/K干燥基板
5.11 熱退火
經過適當時間的熱處理,修復晶體損傷,改善晶體性質。

6 4Mask工藝PR后像素照片
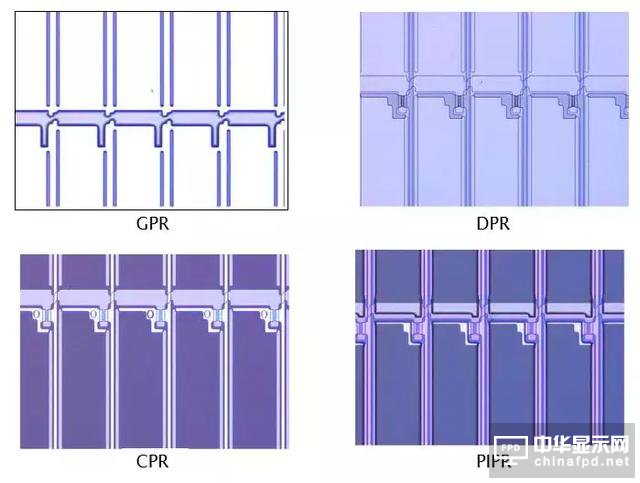
關注我們

公眾號:china_tp
微信名稱:亞威資訊
顯示行業頂級新媒體
掃一掃即可關注我們